QR Code

À propos de nous
Des produits
Contactez-nous

Téléphone

Fax
+86-579-87223657

E-mail

Adresse
Route Wangda, rue Ziyang, comté de Wuyi, ville de Jinhua, province du Zhejiang, Chine
Les substrats en carbure de silicium ont de nombreux défauts et ne peuvent pas être traités directement. Un film mince monocusstal spécifique doit être cultivé sur eux à travers un processus épitaxial pour faire des plaquettes de puce. Ce film mince est la couche épitaxiale. Presque tous les dispositifs en carbure de silicium sont réalisés sur des matériaux épitaxiaux. Les matériaux épitaxiaux homogènes en carbure de silicium de haute qualité sont à la base du développement de dispositifs en carbure de silicium. Les performances des matériaux épitaxiales déterminent directement la réalisation des performances des dispositifs en carbure de silicium.
Les dispositifs en carbure de silicium à courant élevé et à haute fiabilité ont présenté des exigences plus strictes sur la morphologie de la surface, la densité des défauts, le dopage et l'uniformité d'épaisseur des matériaux épitaxiaux. Densité de grande taille et faible et haute densitéEpitaxy en carbure de siliciumest devenu la clé du développement de l'industrie du carbure de silicium.
La préparation de haute qualitéEpitaxy en carbure de siliciumnécessite des processus et des équipements avancés. La méthode de croissance épitaxiale du carbure de silicium la plus largement utilisée est le dépôt de vapeur chimique (CVD), qui présente les avantages d'un contrôle précis de l'épaisseur du film épitaxial et de la concentration de dopage, moins de défauts, du taux de croissance modéré et du contrôle automatique des processus. Il s'agit d'une technologie fiable qui a été commercialisée avec succès.
L'épitaxy CVD en carbure de silicium utilise généralement un équipement CVD de paroi chaude ou de paroi chaude, ce qui garantit la poursuite de la couche épitaxiale 4H Crystal SiC dans des conditions de température de croissance plus élevées (1500-1700 ℃). Après des années de développement, la paroi chaude ou la MCV de la paroi chaude peut être divisée en réacteurs de structure horizontale horizontale et réacteurs verticaux de structure verticale en fonction de la relation entre la direction du débit de gaz d'entrée et de la surface du substrat.
La qualité de la fournaise épitaxiale en carbure de silicium a principalement trois indicateurs. Le premier est la performance de croissance épitaxiale, y compris l'uniformité d'épaisseur, l'uniformité du dopage, le taux de défaut et le taux de croissance; La seconde est la performance de température de l'équipement lui-même, y compris le taux de chauffage / refroidissement, la température maximale, l'uniformité de la température; et enfin les performances des coûts de l'équipement lui-même, y compris le prix unitaire et la capacité de production.
Les MCV horizontaux à paroi chaude, les MCV planétaires à la paroi chaude et les MCV verticaux de mur quasi-chauffés sont les solutions technologiques d'équipement épitaxiales grand public qui ont été appliquées commercialement à ce stade. Les trois équipements techniques ont également leurs propres caractéristiques et peuvent être sélectionnés en fonction des besoins. Le diagramme de structure est illustré dans la figure ci-dessous:

Le système de MCV horizontal de la paroi chaude est généralement un système de croissance de grande taille unique entraîné par la flottation et la rotation de l'air. Il est facile de réaliser de bons indicateurs in-wafer. Le modèle représentatif est PE1O6 de LPE Company en Italie. Cette machine peut réaliser le chargement automatique et le déchargement des plaquettes à 900 ℃. Les principales caractéristiques sont un taux de croissance élevé, un cycle épitaxial court, une bonne cohérence au sein de la tranche et entre les fours, etc. Il a la part de marché la plus élevée en Chine.

Selon les rapports officiels du LPE, combinés à l'utilisation des principaux utilisateurs, les produits épitaxiaux de 100-150 mm (4-6 pouces) 4H-SIC avec une épaisseur inférieure à 30 μm produits par le four épitaxial PE1O6 peuvent atteindre de manière stable les indicateurs suivants: Épaisseur épitaxiale intra-wafer ≤2%, conformité intra-wafor intra-wafor densité ≤1cm-2, zone sans défaut de surface (cellule unitaire 2 mm × 2 mm) ≥90%.
Des entreprises nationales telles que JSG, CETC 48, Naura et Naso ont développé un équipement épitaxial monolithique en carbure de silicium avec des fonctions similaires et ont atteint des expéditions à grande échelle. Par exemple, en février 2023, JSG a publié un équipement épitaxial SIC à double part de 6 pouces. L'équipement utilise les couches supérieures et inférieures des couches supérieures et inférieures des parties de graphite de la chambre de réaction pour développer deux plateaux épitaxiaux dans une seule fournaise, et les gaz de processus supérieur et inférieur peuvent être régulés séparément, avec une différence de température de ≤5 ° CSic revêtement en demi-lune.Nous fournissons des pièces de 6 pouces et 8 pouces en demi-lune aux utilisateurs.

Le système de MCV planétaire à paroi chaude, avec un arrangement planétaire de la base, est caractérisé par la croissance de plusieurs plaquettes dans une seule fournaise et une efficacité de production élevée. Les modèles représentatifs sont les équipements épitaxiaux AIXG5WC (8x150 mm) et G10-SIC (9 × 150 mm ou 6 × 200 mm) d'Aixtron de l'Allemagne.
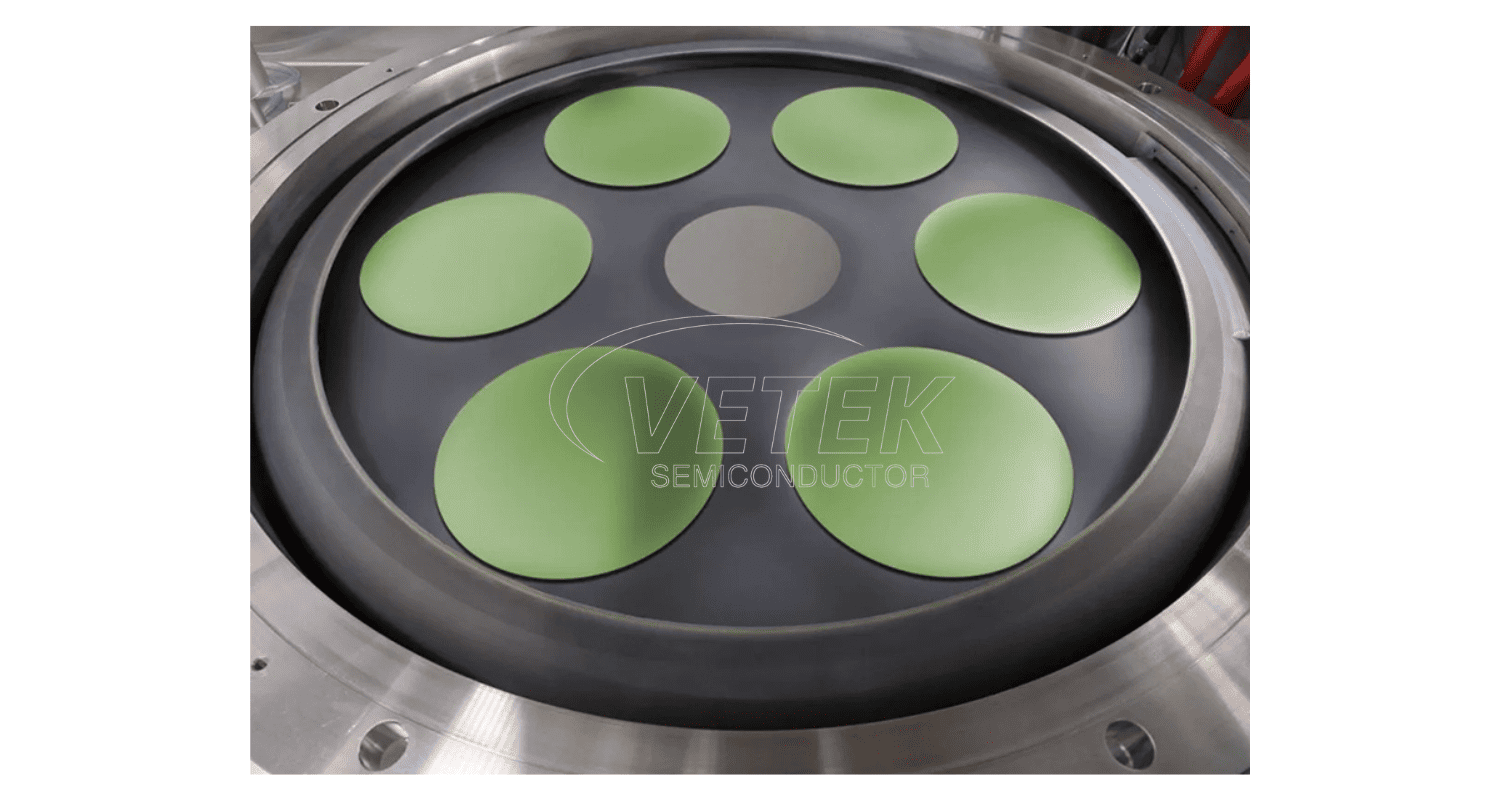
Selon le rapport officiel d'Aixtron, les produits à plaquettes épitaxiales 4H de 6 pouces 4H-SIC avec une épaisseur de 10 μm produites par le fournace épitaxial G10 peuvent obtenir de manière stable les indicateurs suivants: Inter-wafer épitaxial épaisseur d'épaisseur de ± 2,5%, épaisseur épitaxiale intra-wafer. Concentration non uniformité <2%.
Jusqu'à présent, ce type de modèle est rarement utilisé par les utilisateurs domestiques, et les données de production par lots sont insuffisantes, ce qui restreint dans une certaine mesure son application d'ingénierie. De plus, en raison des obstacles techniques élevés des fours épitaxiaux multiples en termes de champ de température et de contrôle du champ d'écoulement, le développement d'un équipement domestique similaire est toujours au stade de la recherche et du développement, et il n'y a pas de modèle alternatif.
Le système de MCV vertical à paroi quasi-chaleur tourne principalement à grande vitesse grâce à une assistance mécanique externe. Sa caractéristique est que l'épaisseur de la couche visqueuse est effectivement réduite par une pression de la chambre de réaction plus faible, augmentant ainsi le taux de croissance épitaxial. Dans le même temps, sa chambre de réaction n'a pas de paroi supérieure sur laquelle les particules de SiC peuvent être déposées, et il n'est pas facile de produire des objets qui tombent. Il a un avantage inhérent à la lutte contre les défauts. Les modèles représentatifs sont les furnaces épitaxiales de la vie unique Epirevos6 et Epirevos8 de Nuflare au Japon.
Selon Nuflare, le taux de croissance du dispositif Epirevos6 peut atteindre plus de 50 μm / h, et la densité de défaut de surface de la tranche épitaxiale peut être contrôlée en dessous de 0,1 cm-²; En termes de contrôle de l'uniformité, l'ingénieur Nuflare Yoshiaki Daigo a rapporté les résultats de l'uniformité intra-wafer d'une tranche épitaxiale de 6 pouces de 10 μm d'épaisseur cultivée en utilisant Epirevos6, et l'épaisseur intra-wafer et la concentration de dopage non uniformité ont atteint 1% et 2,6%.Cylindre de graphite supérieur.
À l'heure actuelle, les fabricants d'équipements intérieurs tels que la troisième génération de base et le JSG ont conçu et lancé des équipements épitaxiaux avec des fonctions similaires, mais ils n'ont pas été utilisés à grande échelle.
En général, les trois types d'équipements ont leurs propres caractéristiques et occupent une certaine part de marché dans différents besoins d'application:
La structure de MCV horizontale à la paroi chaude comprend un taux de croissance ultra-rapide, une qualité et une uniformité, un fonctionnement et une maintenance de l'équipement simple et des applications de production à grande échelle matures. Cependant, en raison du type de pavillon unique et de la maintenance fréquente, l'efficacité de production est faible; Le MCV planétaire à la paroi chaude adopte généralement une structure de plateau 6 (pièce) × 100 mm (4 pouces) ou 8 (pièce) × 150 mm (6 pouces), ce qui améliore considérablement l'efficacité de production de l'équipement en termes de capacité de production, mais il est difficile de contrôler la cohérence des pièces multiples, et le rendement de production est toujours le plus gros problème; Le MCV vertical à paroi quasi-chaleur a une structure complexe, et le contrôle de la qualité des défauts de la production de la plaquette épitaxiale est excellent, ce qui nécessite une entretien et une expérience d'utilisation de l'équipement extrêmement riche.
Taux de croissance rapide
simple Structure de l'équipement et
maintenance pratique
Grande capacité de production
Efficacité de production élevée
Bon contrôle des défauts du produit
Chambre de réaction longue
cycle de maintenance
Structure complexe
difficile à contrôler
cohérence des produits
Structure complexe de l'équipement,
entretien difficile
Représentant
équipement
fabricants
CVD horizontal mural chaud
CWD planétaire par mur chaud
CTD vertical vertical mural quasi-chaud
Avantages
Désavantage
Cycle de maintenance court
Italie LPE, Japon Tél
Allemagne Aixtron
Japon Nuflare
Avec le développement continu de l'industrie, ces trois types d'équipement seront optimisés et améliorés de manière itérative en termes de structure, et la configuration de l'équipement deviendra de plus en plus parfaite, jouant un rôle important dans la correspondance des spécifications des plaquettes épitaxiales avec différentes épaisseurs et exigences de défaut.



+86-579-87223657


Route Wangda, rue Ziyang, comté de Wuyi, ville de Jinhua, province du Zhejiang, Chine
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Tous droits réservés.
Links | Sitemap | RSS | XML | politique de confidentialité |
