QR Code

À propos de nous
Des produits
Contactez-nous

Téléphone

Fax
+86-579-87223657

E-mail

Adresse
Route Wangda, rue Ziyang, comté de Wuyi, ville de Jinhua, province du Zhejiang, Chine
Le polissage chimico-mécanique (CMP) élimine les excès de matière et les défauts de surface grâce à l'action combinée de réactions chimiques et d'abrasion mécanique. Il s’agit d’un processus clé pour parvenir à une planarisation globale de la surface de la tranche et il est indispensable pour les interconnexions multicouches en cuivre et les structures diélectriques à faible k. Dans la fabrication pratique, le CMP n'est pas un processus d'élimination parfaitement uniforme ; cela donne lieu à des défauts typiques dépendant du motif, parmi lesquels le bombage et l'érosion sont les plus importants. Ces défauts affectent directement la géométrie des couches d'interconnexion et leurs caractéristiques électriques.
Le bombage fait référence à l'élimination excessive de matériaux conducteurs relativement mous (tels que le cuivre) pendant le CMP, conduisant à un profil concave en forme de plat à l'intérieur d'une seule ligne métallique ou d'une grande zone métallique. En coupe transversale, le centre de la ligne métallique se situe plus bas que ses deux bords et la surface diélectrique environnante. Ce phénomène est fréquemment observé dans les zones métalliques de type lignes larges, plots ou blocs. Son mécanisme de formation est principalement lié aux différences de dureté des matériaux et à la déformation du tampon de polissage sur de larges éléments métalliques : les métaux mous sont plus sensibles aux composants chimiques et aux abrasifs présents dans la boue, et la pression de contact locale du tampon augmente sur les éléments larges, ce qui fait que le taux d'enlèvement au centre du métal dépasse celui sur les bords. En conséquence, la profondeur du bombage augmente généralement avec la largeur du trait et le temps de surpolissage.
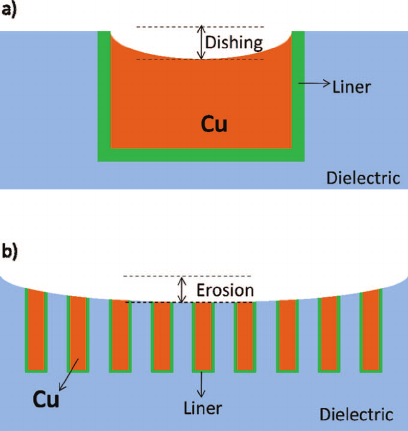
L'érosion est caractérisée par le fait que la hauteur globale de la surface dans les régions à forte densité de motifs (telles que les réseaux de lignes métalliques denses ou les zones avec un remplissage factice dense) est inférieure à celle des régions clairsemées environnantes après la CMP. Essentiellement, il s’agit d’un enlèvement excessif de matière au niveau de la région, en fonction de la densité des modèles. Dans les régions denses, le métal et le diélectrique fournissent ensemble une plus grande surface de contact efficace, et le frottement mécanique et l'action chimique du tampon et de la boue sont plus forts. Par conséquent, les taux moyens d’élimination du métal et du diélectrique sont plus élevés que dans les régions à faible densité. Au fur et à mesure du polissage et du surpolissage, l'empilement métal-diélectrique dans les zones denses devient globalement plus mince, formant un pas de hauteur mesurable, et le degré d'érosion augmente avec la densité locale du motif et la charge du processus.
Du point de vue des performances des dispositifs et des processus, le bombage et l’érosion ont de multiples impacts négatifs sur les produits semi-conducteurs. Le plating réduit la surface de section efficace du métal, ce qui entraîne une résistance d'interconnexion plus élevée et une chute IR, ce qui à son tour entraîne un retard du signal et une marge de synchronisation réduite sur les chemins critiques. Les variations de l'épaisseur diélectrique provoquées par l'érosion modifient la capacité parasite entre les lignes métalliques et la répartition du retard RC, compromettant l'uniformité des caractéristiques électriques à travers la puce. De plus, l’amincissement local du diélectrique et la concentration du champ électrique affectent le comportement de claquage et la fiabilité à long terme des diélectriques intermétalliques. Au niveau de l'intégration, une topographie de surface excessive augmente la difficulté de mise au point et d'alignement de la lithographie, dégrade l'uniformité du dépôt et de la gravure ultérieurs du film et peut induire des défauts tels que des résidus métalliques. Ces problèmes se manifestent finalement par des fluctuations de rendement et une fenêtre de processus réduite. Par conséquent, dans l'ingénierie pratique, il est nécessaire de contrôler le bombage et l'érosion dans des limites spécifiées grâce à l'égalisation de la densité de disposition, à l'optimisation depolissage mdépêchez-voussélectivité et réglage fin des paramètres du processus CMP, afin de garantir la planéité des structures d'interconnexion, des performances électriques stables et une fabrication robuste à grand volume.



+86-579-87223657


Route Wangda, rue Ziyang, comté de Wuyi, ville de Jinhua, province du Zhejiang, Chine
Copyright © 2024 WuYi TianYao Advanced Material Tech.Co., Ltd. Tous droits réservés.
Links | Sitemap | RSS | XML | politique de confidentialité |
